一、SIP系统级封装概念
随着半导体器件、集成电路领域的不断发展,SIP系统级封装技术成为企业青睐的工艺,我司SIP产线拥有先进的半导体前道设备和工艺制造,在SIP封装、可靠性测试等短接大大缩短研发和验证周期。这篇文章可以帮助用户更好SIP系统级封装相关内容。
从架构上来讲,SIP是将多种半导体芯片,包括处理器、存储器等功能芯片集成在一个封装内,从而实现一个基本完整的功能,不再用PCB板来作为承载芯片连接之间的载体,可以解决因为PCB自身的先天不足带来系统性能遇到瓶颈的问题。
需要注意的是,SIP不仅是简单地将芯片集成在一起,需要根据系统的需要进行合理的裁剪和设计,采用不同的结构和工艺来实现。另外,SiP还具有开发周期短;功能更多;功耗更低,性能更优良、成本价格更低,体积更小,质量更轻等优点。
二、SIP系统级封装优点如下:
1.封装效率高
SIP封装技术在同一封装体内加多个芯片,大大减少了封装体积,提离了封装效率。两芯片加使面明比增加到170%,三芯片装可使面积比增至250%。
2.兼容性能
SIP封装将不同的工艺、材料制作的芯片封形成一个系统,可实现嵌入集或化天源元件的梦幻组合,无线电和便携式电子整机中现用的无源元件至少可被做入30-50%,基至可将Si,GaAs.InP的芯片组合一体化封装。
3.降低系统成本
SIP可提供低功耗和低噪声的系统级连接,在较高的威率下工作可以获得较宽的带宽。和几乎与SOC相等的总线带宽。一个专用的集成电路系统,采用SIP封装技术可比SOC节省更多的系统设计和生产费用。
4.物理尺寸小
SIP封装体的厚度不断减少,最先进的技术可实现五层堆叠芯片只有1.0mm厚的超薄封装,三叠层芯片封装的重量减轻35%。
5.电性能高
SIP封装技术可以使多个封装合二为一,可使总的焊点大为减少,也可以显着减小封装体积、重量,缩短元件的连接路线,从而使电性能得以提高。
6.低功耗
SIP封装可提供低功耗和低噪音的系统级连接,在较高的烦车下工作可获得几乎与SOC相等的汇流排宽度。
7.稳定性好
SIP封装具有良好的抗机械和化学腐性的能力以及高的可靠性。
8.使用广泛
与传统的芯片不同,SIP封装不仅可以处理数字系统,还可以应用传感器、微机电MEMS等领域。
三、SIP系统级封装类型
SiP封装技术以排列方式进行区分:可大体分为平面式2D封装和3D封装的结构。相对于2D封装,将多芯片采用堆叠的3D封装技术构成立体封装,可以增加使用晶圆或模块的数量,从而在垂直方向上增加了可放置晶圆的层数,进一步增强SIP技术的功能整合能力。
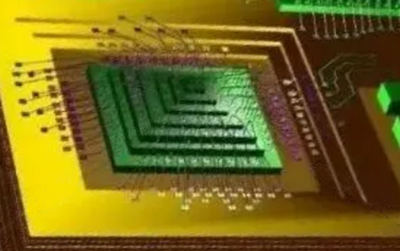
四、SIP系统级封装常见工艺
1.圆片减薄与切割
圆⽚减薄是指从圆⽚背⾯采⽤机械或化学机械(CMP)⽅式进⾏研磨,将圆⽚减薄到适合封装的程度。由于圆⽚的尺⼨越来越⼤,为了增加圆⽚的机械强度,防⽌在加⼯过程中发⽣变形、开裂,其厚度也⼀直在增加。但是随着系统朝轻薄短⼩的⽅向 发展,芯⽚封装后模块的厚度变得越来越薄,因此在封装之前⼀定要将圆⽚的厚度减薄到可以接受的程度,以满⾜芯⽚装配的要求。圆⽚减薄后,可以进⾏划⽚,较⽼式的划⽚机是⼿动操作的,现在⼀般的划⽚机都已实现全⾃动化。⽆论是部分划线还是完全 分割硅⽚,⽬前均采⽤锯⼑,因为它划出的边缘整齐,很少有碎屑和裂⼝产⽣。
2.芯片粘结
已切割下来的芯⽚要贴装到框架的中间焊盘上。焊盘的尺⼨要和芯⽚⼤⼩相匹配,若焊盘尺⼨太⼤,则会导致引线跨度太⼤, 在转移成型过程中会由于流动产⽣的应⼒⽽造成引线弯曲及芯⽚位移现象。贴装的⽅式可以是⽤软焊料(指 Pb-Sn 合⾦,尤其是含 Sn 的合⾦)、Au-Si 低共熔合⾦等焊接到基板上,在塑料封装中最常⽤的⽅法是使⽤聚合物粘结剂粘贴到⾦属框架上。
3.引线键合
在塑料封装中使⽤的引线主要是⾦线,其直径⼀般为0.025mm~0.032mm。引线的长度常在1.5mm~3mm之间,⽽弧圈的⾼度可⽐芯⽚所在平⾯⾼ 0.75mm。
键合技术有热压焊、热超声焊等。这些技术优点是容易形成球形(即焊球技术),并防⽌⾦线氧化。为了降低成本,也在研究⽤其他⾦属丝,如铝、铜、银、钯等来替代⾦丝键合。热压焊的条件是两种⾦属表⾯紧紧接触,控制时间、温度、压⼒,使得两种⾦属发⽣连接。表⾯粗糙(不平整)、有氧化层形成或是有化学沾污、吸潮等都会影响到键合效果,降低键合强度。热压 焊的温度在 300℃~400℃,时间⼀般为 40ms(通常,加上寻找键合位置等程序,键合速度是每秒⼆线)。超声焊的优点是可避免⾼温,因为它⽤20kHz~60kHz的超声振动提供焊接所需的能量,所以焊接温度可以降低⼀些。将热和超声能量同时⽤于 键合,就是所谓的热超声焊。与热压焊相⽐,热超声焊最⼤的优点是将键合温度从 350℃降到250℃左右(也有⼈认为可以⽤100℃~150℃的条件),这可以⼤⼤降低在铝焊盘上形成 Au-Al ⾦属间化合物的可能性,延长器件寿命,同时降低了电路参数的漂移。在引线键合⽅⾯的改进主要是因为需要越来越薄的封装,有些超薄封装的厚度仅有0.4mm 左右。
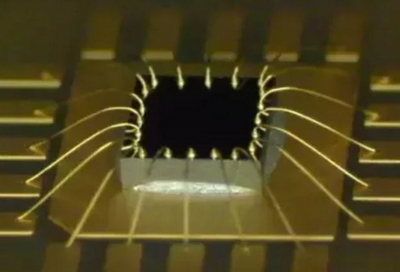
4.分离⼯艺
为了提⾼⽣产效率和节约材料,⼤多数 SIP 的组装⼯作都是以阵列组合的⽅式进⾏,在完成模塑与测试⼯序以后进⾏划分, 分割成为单个的器件。划分分割可以采⽤锯开或者冲压⼯艺,锯开⼯艺灵活性⽐较强,也不需要多少专⽤⼯具,冲压⼯艺则⽣ 产效率⽐较⾼、成本较低,但是需要使⽤专门的⼯具。
5.倒装焊
和引线键合⼯艺相⽐较倒装焊⼯艺具有以下⼏个优点:
(1) 倒装焊技术克服了引线键合焊盘中⼼距极限的问题;
(2) 在芯⽚的电源 /地线分布设计上给电⼦设计师提供了更多的便利;
(3) 通过缩短互联长度,减⼩ RC 延迟,为⾼频率、⼤功率器件提供更完善的信号;
(4) 热性能优良,芯⽚背⾯可安装散热器;
(5) 可靠性⾼,由于芯⽚下填料的作⽤,使封装抗疲劳寿命增强;
(6) 便于返修。